什么是氧化金属横向电场效应晶体管 ?
氧化金属横向电场效应晶体管(英语:Metal-Oxide-Semiconductor Field-Effect Transistor,缩写:MOSFET,简称金属氧半场效应管,也称为MOS管),是一种可以广泛使用在模拟电路与数字电路的场效应管。金属氧化物半导体场效应管依照其沟道极性的不同,可分为电子占多数的N沟道型与空穴占多数的P沟道型,通常被称为N型金氧半场效应管(nMOSFET或NMOS)与P型金氧半场效应管(pMOSFET或PMOS)。
以金属氧半场效应管(MOSFET)的命名来看,事实上会让人得到错误的印象。因为MOSFET跟英文单字“metal(金属)”的第一个字母M,在当下大部分同类的器件里是不存在的。早期金氧半场效应管的栅极使用金属作为材料,但由于多晶硅在制造工艺中更耐高温等特点,许多金氧半场效应管栅极采用后者而非前者金属。然而,随着半导体特征尺寸的不断缩小,金属作为栅极材料最近又再次得到了研究人员的注意。
金氧半场效应管在概念上属于绝缘栅极场效应管(Insulated-Gate Field Effect Transistor,IGFET)。而绝缘栅极场效应管的栅极绝缘层,有可能是其他物质,而非金氧半场效应管使用的氧化层。有些人在提到拥有多晶硅栅极的场效应管器件时比较喜欢用IGFET,但是这些IGFET多半指的是金氧半场效应管。
金氧半场效应管里的氧化层位于其沟道上方,依照其工作电压的不同,这层氧化物的厚度仅有数十至数百埃(Å)不等,通常材料是二氧化硅(SiO2),不过有些新的高级制程已经可以使用如氮氧化硅(silicon oxynitride, SiON)做为氧化层之用。
今日半导体器件的材料通常以硅为首选,但是也有些半导体公司发展出使用其他半导体材料的制程,当中最著名的例如国际商业机器股份有限公司使用硅与锗的混合物所发展的硅锗制程(SiGe process)。而可惜的是很多拥有良好电性的半导体材料,如砷化镓(GaAs),因为无法在表面长出质量够好的氧化层,所以无法用来制造金氧半场效应管器件。
当一个够大的电位差施于金氧半场效应管的栅极与源极之间时,电场会在氧化层下方的半导体表面形成感应电荷,而这时就会形成反转沟道(inversion channel)。沟道的极性与其漏极(drain)与源极相同,假设漏极和源极是n型,那么沟道也会是n型。沟道形成后,金氧半场效应管即可让电流通过,而依据施于栅极的电压值不同,可由金氧半场效应管的沟道流过的电流大小亦会受其控制而改变。
MOSFET历史
场效应晶体管的基本原理最早由朱利叶斯·埃德加·利连费尔德于1925年作为加拿大专利申请,随后于1926年获得美国专利。1934年,发明家奥斯卡·海尔在欧洲独立申请了类似装置的专利。
20世纪40年代,贝尔实验室的科学家威廉·肖克利、约翰·巴丁和沃尔特·豪泽·布拉特因尝试制造一种场效应器件,最终发现了晶体管效应。然而,由于表面态问题,其结构未能展现预期效应:即半导体表面上的陷阱,将电子固定在不动状态。由于没有表面钝化,他们只能制造BJT和晶闸管晶体管。
1955年,卡尔·弗罗施和林肯·德里克意外在硅晶圆上生长出一层二氧化硅,观察到表面钝化效应。到1957年,弗罗施和德里克利用掩蔽和预沉积,能够制造二氧化硅场效应晶体管;第一批平面晶体管,其极极和源极在同一表面相邻。他们证明二氧化硅能绝缘保护硅晶圆,防止掺杂剂扩散到晶圆中。在贝尔实验室,弗罗施和德里克技术及晶体管的重要性立即被认识到。他们的研究成果以BTL备忘录的形式在贝尔实验室流传,最终于1957年发表。在肖克利半导体公司,肖克利于1956年12月将该文章的预印本分发给所有高级员工,包括让·霍尔尼,,后者于1959年在飞兆半导体发明了平面工艺。
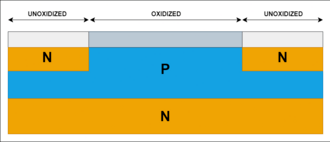
此后,J.R. Ligenza和W.G. Spitzer研究了热生长氧化物的机制,制造了高质量的Si/SiO2堆栈,并于1960年发表了他们的成果。在这项研究之后,穆罕默德·阿塔拉和达翁·康于1959年提出了硅MOS晶体管,并于1960年与贝尔实验室团队成功演示了可工作的MOS器件。他们的团队包括制造该装置的E. E. LaBate和E. I. Povilonis;M. O. Thurston、L. A. D'Asaro 和 J. R. Ligenza 开发了扩散工艺,H. K. Gummel 和 R. Lindner 则对该器件进行了表征。这是从利连费尔德开始数十年场效应研究的结晶。
贝尔实验室的第一个MOS晶体管比当时的双极型晶体管慢约100倍,最初被认为较差。尽管如此,Kahng指出该器件的多项优势,尤其是制造简便及其在集成电路中的应用。
本文简要介绍MOSFET,即金属氧化物半导体场效应晶体管。我们将了解不同类型的MOSFET(增强型和耗尽型)、其内部结构、一个以MOSFET为开关的电路示例以及一些常见应用。
晶体管及其类型
晶体管,改变世界的发明。它们是半导体器件,既可作为电控开关,也可作为信号放大器。晶体管有各种形状、尺寸和设计,但本质上,所有晶体管都归入两大类。它们是:
- 双极性结晶体管(BJT)
- 场效应晶体管(ECT)
BJT和FET有两个主要区别。第一个区别是,在BJT中,多数和少数电荷载流子共同负责电流导通,而在场效应晶体中,只有多数载流子参与。
另一个非常重要的区别是,BJT本质上是一种电流控制器件,晶体管基极的电流决定了集电极与发射极之间流动的电流大小。在场效应晶体(FET)中,栅极(场效应晶体中相当于BJT中的基极)处的电压决定了另外两个端子之间的电流流动。
场效应体测试(FET)再次分为两种类型:
- 结场效应晶体管(JFET)
- 金属氧化物半导体场效应晶体管或MOSFET
MOSFET类型
金属氧化物半导体场效应晶体管(MOSFET)是一种场效应晶体管。在这些晶体管中,栅极端子与承载通道电绝缘,因此也称为绝缘栅场效应晶体(IG-FET)。由于栅极和源端之间的绝缘,MOSFET的输入电阻可能非常高(通常约为10¹⁹欧姆)。
与JFET类似,当栅极端子无电流流入时,MOSFET也充当电压控制电阻。栅极端子上的低电压控制了源极与汲极之间通道的电流流动。如今,MOSFET晶体管主要用于电子电路应用,而非JFET。
MOSFET还有三个端子,分别是漏极(D)、源极(S)和栅极(G),以及一个(可选的)端子,称为基板或本体(B)。MOSFET也有N信道(NMOS)和P信道(PMOS)两种类型。MOSFET基本上分为两种形式。它们是:
- 耗尽类型
- 增强类型
耗尽类型MOSFET
耗尽型MOSFET晶体管相当于“常闭”开关。耗尽型晶体管需要栅极-源电压(VGS)来关闭设备。
上图展示了N通道和P通道类型中MOSFET耗尽模的符号。在上述符号中,我们可以观察到第四端子(基板)连接到地线,但在离散MOSFET中,它连接到源端。连接排水管和源头端子的连续粗线代表排水类型。箭头符号表示信道类型,如N信道或P信道。
在这种类型的MOSFET中,栅极极下方沉积一层薄薄的硅。耗尽模MOSFET晶体管通常在零栅极-源电压(VGS)时导通。耗尽MOSFET的通道导电性低于增强型MOSFET。
增强型MOSFET
增强模式MOSFET相当于“常开”开关,这类晶体管需要门极-源电压来使器件开通。N通道和P通道增强模式MOSFET的符号如下所示。

这里,我们可以观察到源极和漏极之间连接着一条断线,这代表了增强模式类型。在增强模式MOSFET中,电导率通过增加氧化层而增加,氧化层将载流子加入通道。
通常,这一氧化层被称为“反演层”。沟道在排水沟和源头之间形成,采用与基板相反的类型,例如N通道用P型基板,P通道用N型基板。由于电子或空穴导致的通道导电性分别取决于N型或P型通道。
MOSFET的结构

- MOSFET的基本结构如上图所示。与JFET的结构相比,MOSFET的结构有很大不同。在MOSFET的增强和耗尽模式下,闸极电压都会产生电场,改变流电荷载流子,如N通道的电子和P通道的空穴。
这里,我们可以看到栅极端子位于薄金属氧化物绝缘层之上,两个N型区域位于漏极和源极下方。
在上述MOSFET结构中,漏极与源源之间的通道为N型,形成于P型基板的相反方向。可以很容易地对MOSFET栅极极性进行偏置,分别是正极(+ve)或负极性(-ve)。
如果栅极端子没有偏置,则MOSFET通常处于非导通状态,因此这些MOSFET被用于制造开关和逻辑门。MOSFET的耗尽和增强模式均有N通道和P通道两种类型。
耗尽模式MOSFET
耗尽模式MOSFET通常被称为“开关导通”器件,因为当栅极无偏压时,这些晶体管通常闭合。如果栅极电压在正值下增加,则在耗尽模式下信道宽度会增加。
因此,漏极电流为D通过水道的通道增加。如果施加的栅极电压较负,信道宽度会非常小,MOSFET可能会进入截止区。耗尽模MOSFET是一种在电子电路中很少使用的晶体管类型。
下图显示了耗尽模式MOSFET的特征曲线。
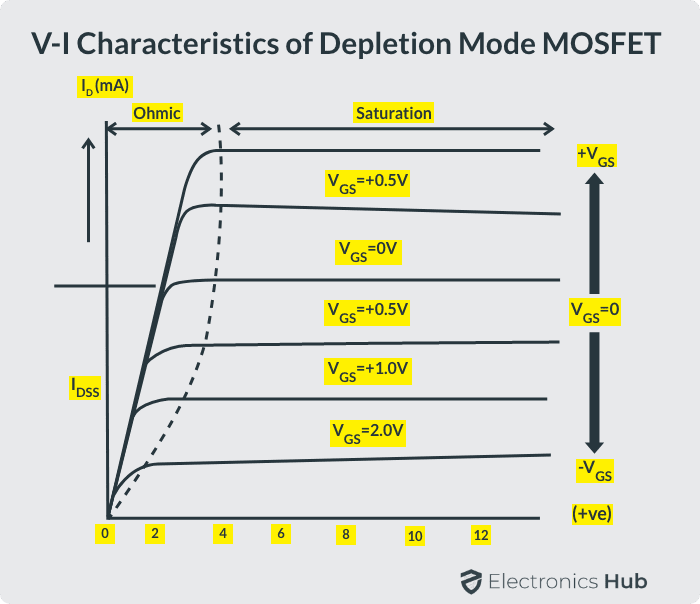
耗尽模MOSFET晶体管的V-I特性如上所述。该特性主要决定了漏极-源电压(V)之间的关系DS)和漏斗电流(I)D).栅极处的小电压控制通道中的电流流动。

漏极与源极之间的通道作为良好导体,在栅极端子处保持零偏置电压。当栅极电压为正时,通道宽度和汲极电流增加;当栅极电压为负时,这两者(通道宽度和汲极电流)会减少。
增强模式
增强模式MOSFET是常用的晶体管类型。这种类型的MOSFET等同于常开开关,因为它在栅极电压为零时不导电。如果正电压(+V)GS)施加在N通道栅极上,然后通道导通,漏极电流通过通道。
如果偏置电压升高为正,通道宽度和漏斗电流会增加到更多。但如果偏置电压为零或负值(-VGS)时晶体管可能关闭,通道处于非导通状态。所以现在我们可以说增强模式的栅极电压增强了信道。
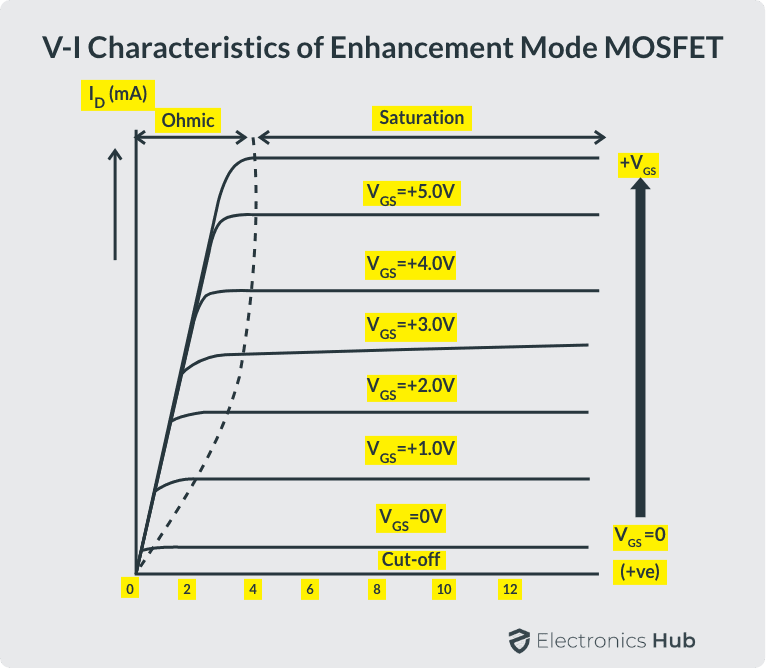
增强模式MOSFET晶体管主要用作电子电路中的开关,因为它们的导通阻和断开阻值低,以及栅极电阻较高。这些晶体管用于制造逻辑门和功率开关电路,如CMOS门,这些电路既有NMOS晶体管,也有PMOS晶体管。
增强模式MOSFET的V-I特性如上图所示,这给出了汲极电流(ID)与汲极-源电压(VDS)之间的关系。从上图中,我们观察到了增强型MOSFET在不同区域(如欧姆、饱和和截止)的行为。

MOSFET晶体管由不同的半导体材料制成。这些MOSFET根据输入端的偏置电压,能够在导电和非导电模式下工作。MOSFET的这一能力使其能够用于开关和放大。
N通道MOSFET放大器
与BJT相比,MOSFET的跨导率非常低,这意味着电压增益不会很大。因此,MOSFET(当然,所有场效应晶体)通常不用于放大器电路。
不过,让我们看看一个单级“A类”放大器电路,采用N通道增强MOSFET。N通道增强模式MOSFET采用统一源配置,是比其他放大器电路更常用的类型。耗尽模MOSFET放大器与JFET放大器非常相似。
MOSFET的输入电阻由输入电阻产生的栅极偏置电阻控制。当栅极电压(V)时,该放大器电路的输出信号会被反相。G当电压(V)升高时,晶体管被打开G)电平时晶体管被关断。
上图展示了通用的MOSFET放大器及其共同源配置。这是A类模式的放大器。这里,电压分压网络由输入电阻R1和R2组成,交流信号的输入电阻为Rin = RG = 1MΩ。
计算上述放大器电路栅极电压和漏极电流的方程如下所示。
VG= (R2/ (R1+ R2)))*VDD
ID= VS/ RS
其中,
VG= 栅极电压
VS= 输入源电压
VDD= 漏极时的供电电压
RS= 源电阻
R1& R2= 输入电阻
下面将讨论MOSFET在整体工作中所处的不同区域。
截止区域:如果栅极-源电压小于阈值电压,则称晶体管处于截止区(即完全关断)。在此区域,漏极电流为零,晶体管作为开路。
VGS< VTH=> IDS= 0
欧姆(线性)区域:如果栅极电压大于阈值电压,且漏极-源电压介于VTH和(VGS – VTH)之间,则称晶体管处于线性区域,在此状态下晶体管充当可变电阻。
VGS> VTH以及 VTH< VDS<(V)GSVGS – VTH) = > MOSFET 作为可变电阻器
饱和区:在该区域,栅极电压远大于阈值电压,漏极电流达到最大值,晶体管处于完全导通状态。在该区域,晶体管充当闭合电路。
VGS>> VTH以及(VGS——TH)< VDS< 2(VGS——TH) => IDS= 最大值
晶体管导通并开始电流流经通道的栅极电压称为阈值电压。N通道器件的阈值电压范围为0.5V至0.7V,P通道器件为-0.5V至-0.8V。
MOSFET晶体管在耗尽和增强模式下根据栅极电压的行为总结如下。
| N通道耗尽 | |||
| N通道增强 | |||
| P通道耗尽 | |||
| P通道增强 |
MOSFET应用
- MOSFET被用于数字集成电路,如微处理器。
- 用于计算器。
- 用于存储器和逻辑CMOS门。
- 用作模拟交换机。
- 用作放大器。
- 用于电力电子和开关电源的应用。
- MOSFET被用作无线电系统的振荡器。
- 用于汽车音响系统和扩声系统。
MOSFET电路符号
常用于金氧半场效应管的电路符号有多种形式,最常见的设计是以一条垂直线代表沟道(Channel),两条和沟道平行的接线代表源极(Source)与漏极(Drain),左方和沟道垂直的接线代表栅极(Gate),如下图所示。有时也会将代表沟道的直线以虚线代替,以区分增强型(enhancement mode,又称增强式)金氧半场效应管或是耗尽型(depletion mode,又称耗尽式)金氧半场效应管。
由于集成电路芯片上的金氧半场效应管为四端器件,所以除了源极(S)、漏极(D)、栅极(G)外,尚有一基极(Bulk或是Body)。金氧半场效应管电路符号中,从沟道往右延伸的箭号方向则可表示此器件为n型或是p型的金氧半场效应管。箭头方向永远从P端指向N端,所以箭头从沟道指向基极端的为p型的金氧半场效应管,或简称PMOS(代表此器件的沟道为p型);反之则代表基极为p型,而沟道为n型,此器件为n型的金氧半场效应管,简称NMOS。在一般分布式金氧半场效应管器件中,通常把基极和源极接在一起,故分布式金氧半场效应管通常为三端器件。而在集成电路中的金氧半场效应管通常因为使用同一个基极(common bulk),所以不标示出基极的极性,而在PMOS的栅极端多加一个圆圈以示区别。
几种常见的MOSFET电路符号,加上结型场效应管一起比较:

上图中的金氧半场效应管符号中,基极端和源极端均接在一起,一般分立元件的MOSFET几乎均如此,但在集成电路中的金氧半场效应管则并不一定是这样连接。通常一颗集成电路芯片中相同沟道的金氧半场效应管都共享同一个基极,故某些情况下的金氧半场效应管可能会使得源极和基极并非直接连在一起,例如串叠式电流源(cascode current source)电路中的部分NMOS就是如此。基极与源极没有直接相连的金氧半场效应管会出现衬底效应(body effect)而部分改变其工作特性,将在后面的章节中详述。
MOSFET工作原理
金氧半场效应管的核心

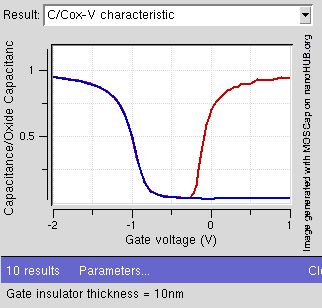
金氧半场效应管在结构上以一个金属—氧化物层—半导体的电容为核心(现在的金氧半场效应管多半以多晶硅取代金属作为其栅极材料),氧化层的材料多半是二氧化硅,其下是作为基极的硅,而其上则是作为栅极的多晶硅。这样的结构正好等于一个电容器,氧化层为电容器中介电质,而电容值由氧化层的厚度与二氧化硅的介电系数来决定。栅极多晶硅与基极的硅则成为MOS电容的两个端点。
当一个电压施加在MOS电容的两端时,半导体的电荷分布也会跟着改变。
累积
考虑一个p型的半导体(空穴浓度为NA)形成的MOS电容,当给电容器加负电压时,电荷增加(如C-V曲线左侧所示)。
耗尽
相反,当一个正的电压VGD施加在栅极与基极端(如图)时,空穴的浓度会减少(称为耗尽,如C-V曲线中间所示),电子的浓度会增加。
反型
当VGS够强时,接近栅极端的电子浓度会超过空穴。这个在p-type半导体中,电子浓度(带负电荷)超过空穴(带正电荷)浓度的区域,便是所谓的反转层(inversion layer),如C-V曲线右侧所示。
MOS电容的特性决定了金氧半场效应管的工作特性,但是一个完整的金氧半场效应管结构还需要一个提供多数载流子(majority carrier)的源极以及接受这些多数载流子的漏极。
金氧半场效应管的结构
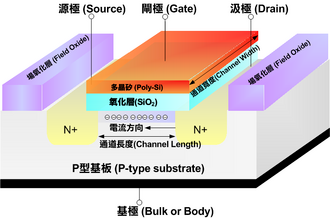
左图是一个n-type金氧半场效应管(以下简称NMOS)的截面图。如前所述,金氧半场效应管的核心是位于中央的MOS电容,而左右两侧则是它的源极与漏极。源极与漏极的特性必须同为n-type(即NMOS)或是同为p-type(即PMOS)。左图NMOS的源极与漏极上标示的“N+”代表着两个意义:(1)N代表掺杂(doped)在源极与漏极区域的杂质极性为N;(2)“+”代表这个区域为高掺杂浓度区域(heavily doped region),也就是此区的电子浓度远高于其他区域。在源极与漏极之间被一个极性相反的区域隔开,也就是所谓的基极(或称基体)区域。如果是NMOS,那么其基体区的掺杂就是p-type。反之对PMOS而言,基体应该是n-type,而源极与漏极则为p-type(而且是重掺杂的P+)。基体的掺杂浓度不需要如源极或漏极那么高,故在左图中没有“+”,作为沟道用。
对这个NMOS而言,真正用来作为沟道、让载流子通过的只有MOS电容正下方半导体的表面区域。当一个正电压施加在栅极上,带负电的电子就会被吸引至表面,形成沟道,让n-type半导体的多数载流子—电子可以从源极流向漏极。如果这个电压被移除,或是放上一个负电压,那么沟道就无法形成,载流子也无法在源极与漏极之间流动,也就是可以透过栅极的电压控制沟道的开关。
假设工作的对象换成PMOS,那么源极与漏极为p-type、基体则是n-type。在PMOS的栅极上施加负电压,则半导体上的空穴会被吸引到表面形成沟道,半导体的多数载流子—空穴则可以从源极流向漏极。假设这个负电压被移除,或是加上正电压,那么沟道无法形成,一样无法让载流子在源极和漏极间流动。
特别要说明的是,源极在金氧半场效应管里的意思是“提供多数载流子的来源”。对NMOS而言,多数载流子是电子;对PMOS而言,多数载流子是空穴。相对的,漏极就是接受多数载流子的端点。
金氧半场效应管的工作模式
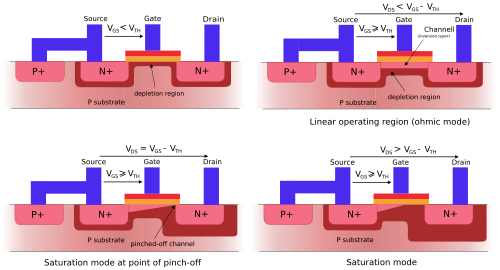

依照在金氧半场效应管的栅极、源极,与漏极等三个端点施加的偏置(bias)不同,金氧半场效应管将有下列三种工作模式。下面将以一种简化代数模型来讨论。现代MOS管的特性比这里展示的代数模型更加复杂。
对于增强型N沟道MOS管来说,这3种工作模式分别为:
- 截止区(亚阈值区或弱反转区)(cutoff, subthreshold or weak-inversion mode)
- 当 |VGS| < |Vth| 时:
- |VGS| 代表栅极到源极的偏置差,|Vth| 为材料的临界电压。这个金氧半场效应管是处在截止(cut-off)的状态,沟道无法反转,并没有足够的多数载流子,电流无法流过这个金氧半场效应管,也就是这个金氧半场效应管不导通。
- 但事实上,金氧半场效应管无电流通过的叙述和现实有些微小的差异。在真实的状况下,因为载流子的能量依循麦克斯韦-玻尔兹曼分布而有高低的差异。虽然金氧半场效应管的沟道没有形成,但仍然有些具有较高能量的载流子可以从半导体表面流至漏极。而若是 |VGS| 略大于零,但小于 |Vth| 的情况下,还会有一个称为弱反转层(weak inversion layer)的区域在半导体表面出现,让更重载子流过。透过弱反转而从源极流至漏极的载流子数量与 |VGS| 的大小之间呈指数的关系,此电流又称为亚阈值电流(subthreshold current)。
- 在一些拥有大量金氧半场效应管的集成电路产品,如动态随机存取存储器(DRAM),亚阈值电流往往会造成额外的能量或功率消耗。
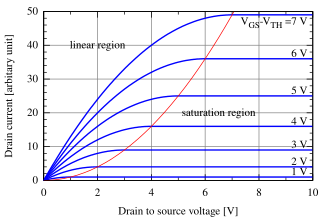

- 线性区(三极区或欧姆区)(linear region, triode mode or ohmic mode)))
- 当VGS>Vth且VGD>Vth时:
- 此处VDS为NMOS漏极至源极的电压,则这颗NMOS为导通的状况,在氧化层下方的沟道也已形成。此时这颗NMOS的行为类似一个压控电阻(voltage-controlled resistor),而由漏极向源极流出的电流大小为:
- μn是载流子迁移率(carrier mobility)、W是金氧半场效应管的栅极宽度、L是金氧半场效应管的栅极长度,而Cox则是栅极氧化层的单位电容大小。在这个区域内,金氧半场效应管的电流—电压关系有如一个线性方程式,因而称为线性区。

- 饱和区(放大区)(saturation or active mode)
- 当VGS>Vth且VGD< Vth时:
- 这颗金氧半场效应管为导通的状况,也形成了沟道让电流通过。但是随着漏极电压增加,超过栅极电压时,会使得接近漏极区的反转层电荷为零,此处的沟道消失(如图),这种状况称之为夹断(pinch-off)。在这种状况下,由源极出发的载流子经由沟道到达夹断点时,会被注入漏极周围的空间电荷区(space charge region),再被电场扫入漏极。此时通过金氧半场效应管的电流与其漏极—源极间的电压VDS无关,只与栅极电压有关,主要原因在于靠近漏极区的栅极电压已经不足以让沟道反转,而造成所能提供的载流子有限,限制住了沟道的电流大小,关系式如下:
- 上述的公式也是理想状况下,金氧半场效应管在饱和区工作的电流与电压关系式。事实上在饱和区的金氧半场效应管漏极电流会因为沟道长度调制效应而改变,并非与VDS全然无关。考虑沟道长度调制效应之后的饱和区电流—电压关系式如下:
- 关于沟道长度调制效应的成因与影响将在后面叙述。
衬底效应
一般而言,源极电压与衬底电压两者接在一起VSB=0,但在实际上VSB>0(对P型衬底而言),此时衬底与源极产生逆偏,使得耗尽区电荷增加,因此使临界电压增加的现象称为衬底效应(Body Effect)。衬底效应通常是负面的,临界电压之变化常会使模拟电路或数字电路设计更加复杂。MOS受到衬底效应影响,临界电压会有所改变,公式如下:
,
是基极与源极之间无电位差时的临界电压,是衬底效应参数,则是与半导体能阶相关的参数(禁带中线与费米能级的差值)。
MOSFET在电子电路上应用的优势
金氧半场效应管在1960年由贝尔实验室的D. Kahng和Martin Atalla首次实现成功,这种器件的工作原理和1947年萧克利等人发明的双载流子接面晶体管截然不同,且因为制造成本低廉与使用面积较小、高集成度的优势,在大规模集成电路或是超大规模集成电路的领域里,重要性远超过BJT。
近年来由于金氧半场效应管器件的性能逐渐提升,除了传统上应用于诸如微处理器、微控制器等数字信号处理的场合上,也有越来越多模拟信号处理的集成电路可以用金氧半场效应管来实现,以下分别介绍这些应用。
数字电路
数字科技的进步,如微处理器运算性能不断提升,带给深入研发新一代金氧半场效应管更多的动力,这也使得金氧半场效应管本身的工作速度越来越快,几乎成为各种半导体有源器件中最快的一种。金氧半场效应管在数字信号处理上最主要的成功来自互补式金属氧化物半导体逻辑电路的发明,这种结构最大的好处是理论上不会有静态的功率损耗,只有在逻辑门的切换动作时才有电流通过。互补式金属氧化物半导体逻辑门最基本的成员是互补式金属氧化物半导体反相器,而所有互补式金属氧化物半导体逻辑门的基本工作都如同反相器一样,同一时间内必定只有一种晶体管(NMOS或是PMOS)处在导通的状态下,另一种必定是截止状态,这使得从电源端到接地端不会有直接导通的路径,大量节省了电流或功率的消耗,也降低了集成电路的发热量。
金氧半场效应管在数字电路上应用的另外一大优势是对直流信号而言,金氧半场效应管的栅极端阻抗为无限大(等效于开路),也就是理论上不会有电流从金氧半场效应管的栅极端流向电路里的接地点,而是完全由电压控制栅极的形式。这让金氧半场效应管和他们最主要的竞争对手BJT相较之下更为省电,而且也更易于驱动。在CMOS逻辑电路里,除了负责驱动芯片外负载(off-chip load)的驱动器外,每一级的逻辑门都只要面对同样是金氧半场效应管的栅极,如此一来较不需考虑逻辑门本身的驱动力。相较之下,BJT的逻辑电路(例如最常见的TTL)就没有这些优势。金氧半场效应管的栅极输入电阻无限大对于电路设计工程师而言亦有其他优点,例如较不需考虑逻辑门输出端的负载效应(loading effect)。
模拟电路
有一段时间,金氧半场效应管并非模拟电路设计工程师的首选,因为模拟电路设计重视的性能参数,如晶体管的跨导或是电流的驱动力上,金氧半场效应管不如BJT来得适合模拟电路的需求。但是随着金氧半场效应管技术的不断演进,今日的CMOS技术也已经可以符合很多模拟电路的规格需求。再加上金氧半场效应管因为结构的关系,没有BJT的一些致命缺点,如热跑脱(thermal runaway)。另外,金氧半场效应管在线性区的压控电阻特性亦可在集成电路里用来取代传统的多晶硅电阻(poly resistor),或是MOS电容本身可以用来取代常用的多晶硅—绝缘体—多晶硅电容(PIP capacitor),甚至在适当的电路控制下可以表现出电感(inductor)的特性,这些好处都是BJT很难提供的。也就是说,金氧半场效应管除了扮演原本晶体管的角色外,也可以用来作为模拟电路中大量使用的被动器件(passive device)。这样的优点让采用金氧半场效应管实现模拟电路不但可以满足规格上的需求,还可以有效缩小芯片的面积,降低生产成本。
随着半导体制造技术的进步,对于集成更多功能至单一芯片的需求也跟着大幅提升,此时用金氧半场效应管设计模拟电路的另外一个优点也随之浮现。为了减少在印刷电路板上使用的集成电路数量、减少封装成本与缩小系统的体积,很多原本独立的模拟芯片与数字芯片被集成至同一个芯片内。金氧半场效应管原本在数字集成电路上就有很大的竞争优势,在模拟集成电路上也大量采用金氧半场效应管之后,把这两种不同功能的电路集成起来的困难度也显著的下降。另外像是某些混合信号电路(Mixed-signal circuits),如模拟数字转换器,也得以利用金氧半场效应管技术设计出性能更好的产品。
近年来还有一种集成金氧半场效应管与BJT各自优点的制程技术:BiCMOS也越来越受欢迎。BJT器件在驱动大电流的能力上仍然比一般的CMOS优异,在可靠度方面也有一些优势,例如不容易被静电放电破坏。所以很多同时需要复噪声号处理以及强大电流驱动能力的集成电路产品会使用BiCMOS技术来制作。
MOSFET的尺寸缩放
过去数十年来,金属氧半场效应管的尺寸不断地变小。早期的集成电路金氧半场效应管制程里,沟道长度约在几个微米的等级。但是到了今日的集成电路制程,这个参数已经缩小到了几十分之一甚至一百分之一。2008年初,Intel开始以45纳米的技术来制造新一代的微处理器,实际的器件沟道长度可能比这个数字还小一些。至90年代末,金氧半场效应管尺寸不断缩小,让集成电路的性能大大提升,而从历史的角度来看,这些技术上的突破和半导体制程的进步有着密不可分的关系。
金属氧半场效应管的尺寸缩小
基于以下几个理由,金氧半场效应管的尺寸能越小越好。
- 越小的金氧半场效应管象征其沟道长度减少,让沟道的等效电阻也减少,可以让更多电流通过。虽然沟道宽度也可能跟着变小而让沟道等效电阻变大,但是如果能降低单位电阻的大小,那么这个问题就可以解决。
- 金氧半场效应管的尺寸变小意味着栅极面积减少,如此可以降低等效的栅极电容。此外,越小的栅极通常会有更薄的栅极氧化层,这可以让前面提到的沟道单位电阻值降低。不过这样的改变同时会让栅极电容反而变得较大,但是和减少的沟道电阻相比,获得的好处仍然多过坏处,而金氧半场效应管在尺寸缩小后的切换速度也会因为上面两个因素加总而变快。
- 金氧半场效应管的面积越小,制造芯片的成本就可以降低,在同样的封装里可以装下更高密度的芯片。一片集成电路制程使用的晶圆尺寸是固定的,所以如果芯片面积越小,同样大小的晶圆就可以产出更多的芯片,于是成本就变得更低了。
尺寸缩小的负面效应
虽然金氧半场效应管尺寸缩小可以带来很多好处,但同时也有很多负面效应伴随而来。
- 金氧半场效应管的尺寸缩小后出现的困难
把金氧半场效应管的尺寸缩小到一微米以下对于半导体制程而言是个挑战,不过现在的新挑战多半来自尺寸越来越小的金氧半场效应管器件所带来过去不曾出现的物理效应。
- 次临限传导
由于金氧半场效应管栅极氧化层的厚度也不断减少,所以栅极电压的上限也随之变少,以免过大的电压造成栅极氧化层雪崩击穿(breakdown)。为了维持同样的性能,金氧半场效应管的临界电压也必须降低,但是这也造成了金氧半场效应管越来越难以完全关闭。也就是说,足以造成金氧半场效应管沟道区发生弱反转的栅极电压会比从前更低,于是所谓的亚阈值电流(subthreshold current)造成的问题会比过去更严重,特别是今日的集成电路芯片所含有的晶体管数量剧增,在某些超大规模集成电路的芯片,次临限传导造成的功率消耗竟然占了总功率消耗的一半以上。
不过反过来说,也有些电路设计会因为金氧半场效应管的次临限传导得到好处,例如需要较高的转导/电流转换比(transconductance-to-current ratio)的电路里,利用次临限传导的金氧半场效应管来达成目的的设计也颇为常见。
- 芯片内部连接导线的寄生电容效应
传统上,互补式金属氧化物半导体逻辑门的切换速度与其器件的栅极电容有关。但是当栅极电容随着金氧半场效应管尺寸变小而减少,同样大小的芯片上可容纳更多晶体管时,连接这些晶体管的金属导线间产生的寄生电容效应就开始主宰逻辑门的切换速度。如何减少这些寄生电容,成了芯片效率能否向上突破的关键之一。
- 芯片发热量增加
当芯片上的晶体管数量大幅增加后,有一个无法避免的问题也跟着发生了,那就是芯片的发热量也大幅增加。一般的集成电路器件在高温下工作可能会导致切换速度受到影响,或是导致可靠度与寿命的问题。在一些发热量非常高的集成电路芯片如微处理器,目前需要使用外加的散热系统来缓和这个问题。
在功率晶体管(Power金氧半场效应管)的领域里,沟道电阻常常会因为温度升高而跟着增加,这样也使得在器件中PN结(pn-junction)导致的功率损耗增加。假设外置的散热系统无法让功率晶体管的温度保持在够低的水准,很有可能让这些功率晶体管遭到热失控的命运。
- 栅极氧化层漏电流增加
栅极氧化层随着金氧半场效应管尺寸变小而越来越薄,目前主流的半导体制程中,甚至已经做出厚度仅有1.2纳米的栅极氧化层,大约等于5个原子叠在一起的厚度而已。在这种尺度下,所有的物理现象都在量子力学所规范的世界内,例如电子的穿隧效应。因为穿隧效应,有些电子有机会越过氧化层所形成的位能障壁(potential barrier)而产生漏电流,这也是今日集成电路芯片功耗的来源之一。
为了解决这个问题,有一些介电系数比二氧化硅更高的物质被用在栅极氧化层中。例如铪和锆的金属氧化物(二氧化铪、二氧化锆)等高介电系数的物质均能有效降低栅极漏电流。栅极氧化层的介电系数增加后,栅极的厚度便能增加而维持一样的电容大小。而较厚的栅极氧化层又可以降低电子透过穿隧效应穿过氧化层的几率,进而降低漏电流。不过利用新材料制作的栅极氧化层也必须考虑其位能障壁的高度,因为这些新材料的传导带和价带和半导体的传导带与价带的差距比二氧化硅小(二氧化硅的传导带和硅之间的高度差约为8ev),所以仍然有可能导致栅极漏电流出现。
- 制程变异更难掌控
现代的半导体制程工序复杂而繁多,任何一道制程都有可能造成集成电路芯片上的器件产生些微变异。当金氧半场效应管等器件越做越小,这些变异所占的比例就可能大幅提升,进而影响电路设计者所预期的性能,这样的变异让电路设计者的工作变得更为困难。
MOSFET的栅极材料
理论上金属氧半场效应管的栅极应该尽可能选择电性良好的导体,多晶硅在经过重掺杂之后的导电性可以用在金氧半场效应管的栅极上,但是并非完美的选择。目前金氧半场效应管使用多晶硅作为的理由如下:
- 金氧半场效应管的临界电压(threshold voltage)主要由栅极与沟道材料的功函数之间的差异来决定,而因为多晶硅本质上是半导体,所以可以借由掺杂不同极性的杂质来改变其功函数。更重要的是,因为多晶硅和底下作为沟道的硅之间能隙相同,因此在降低PMOS或是NMOS的临界电压时可以借由直接调整多晶硅的功函数来达成需求。反过来说,金属材料的功函数并不像半导体那么易于改变,如此一来要降低金氧半场效应管的临界电压就变得比较困难。而且如果想要同时降低PMOS和NMOS的临界电压,将需要两种不同的金属分别做其栅极材料,对于制程又是一个很大的变量。
- 硅—二氧化硅接面经过多年的研究,已经证实这两种材料之间的缺陷(defect)是相对而言比较少的。反之,金属—绝缘体接面的缺陷多,容易在两者之间形成很多表面能阶,大为影响器件的特性。
- 多晶硅的熔点比大多数的金属高,而在现代的半导体制程中习惯在高温下沉积栅极材料以增进器件性能。金属的熔点低,将会影响制程所能使用的温度上限。
不过多晶硅虽然在过去20年是制造金氧半场效应管栅极的标准,但也有若干缺点使得未来仍然有部分金氧半场效应管可能使用金属栅极,这些缺点如下:
- 多晶硅导电性不如金属,限制了信号传递的速度。虽然可以利用掺杂的方式改善其导电性,但成效仍然有限。目前有些融点比较高的金属材料如:钨、钛、钴或是镍被用来和多晶硅制成合金。这类混合材料通常称为金属硅化物。加上了金属硅化物的多晶硅栅极有着比较好的导电特性,而且又能够耐受高温制程。此外因为金属硅化物的位置是在栅极表面,离沟道区较远,所以也不会对金氧半场效应管的临界电压造成太大影响。
- 在栅极、源极与漏极都镀上金属硅化物的制程称为自我对准金属硅化物制程(Self-Aligned Silicide),通常简称salicide制程。
- 当金氧半场效应管的尺寸缩的非常小、栅极氧化层也变得非常薄时,例如现在的制程可以把氧化层缩到一纳米左右的厚度,一种过去没有发现的现象也随之产生,这种现象称为多晶硅耗尽。当金氧半场效应管的反转层形成时,有多晶硅耗尽现象的金氧半场效应管栅极多晶硅靠近氧化层处,会出现一个耗尽层(depletion layer),影响金氧半场效应管导通的特性。要解决这种问题,金属栅极是最好的方案。目前可行的材料包括钽、钨、氮化钽(Tantalum Nitride),或是氮化钛(Titanium Nitride)。这些金属栅极通常和高介电系数物质形成的氧化层一起构成MOS电容。另外一种解决方案是将多晶硅完全的合金化,称为FUSI(FUlly-SIlicide polysilicon gate)制程。
各种常见的MOSFET技术
双栅极金氧半场效应管
双栅极(dual-gate)金氧半场效应管通常用在射频集成电路中,这种金氧半场效应管的两个栅极都可以控制电流大小。在射频电路的应用上,双栅极金氧半场效应管的第二个栅极大多数用来做增益、混频器或是频率转换的控制。
耗尽式MOSFETS
一般而言,耗尽式(depletion mode)金氧半场效应管比前述的加强式(enhancement mode)金氧半场效应管少见。耗尽式金氧半场效应管在制造过程中改变掺杂到沟道的杂质浓度,使得这种金氧半场效应管的栅极就算没有加电压,沟道仍然存在。如果想要关闭沟道,则必须在栅极施加负电压(对NMOS而言)。耗尽式金氧半场效应管是属于“常闭型”(normally-closed,ON)的开关,而相对的,加强式金氧半场效应管则属于“常断型”(normally-open,OFF)的开关。
NMOS逻辑
同样驱动能力的NMOS通常比PMOS所占用的面积小,因此如果只在逻辑门的设计上使用NMOS的话也能缩小芯片面积。不过NMOS逻辑虽然占的面积小,却无法像CMOS逻辑一样做到不消耗静态功率,因此在1980年代中期后已经渐渐退出市场,目前以CMOS为主流。
功率金氧半场效应管

功率金氧半场效应管(Power MOSFET)和前述的金氧半场效应管器件在结构上就有着显著的差异。一般集成电路里的金氧半场效应管都是平面式(planar)的结构,晶体管内的各端点都离芯片表面只有几个微米的距离。而所有的功率器件都是垂直式(vertical)的结构,让器件可以同时承受高电压与高电流的工作环境。一个功率金氧半场效应管能耐受的电压是杂质掺杂浓度与n-type外延层(epitaxial layer)厚度的函数,而能通过的电流则和器件的沟道宽度有关,沟道越宽则能容纳越多电流。对于一个平面结构的金氧半场效应管而言,能承受的电流以及击穿电压的多寡都和其沟道的长宽大小有关。对垂直结构的金氧半场效应管来说,器件的面积和其能容纳的电流大约成正比,外延层厚度则和其击穿电压成正比。
值得一提的是采用平面式结构的功率金氧半场效应管也并非不存在,这类器件主要用在高级的音响放大器中。平面式的功率金氧半场效应管在饱和区的特性比垂直结构的对手更好。垂直式功率金氧半场效应管则多半用来做开关切换之用,取其导通电阻(turn-on resistance)非常小的优点。
DMOS
DMOS是双重扩散金氧半场效应管(Double-Diffused金氧半场效应管)的缩写,大部分的功率金氧半场效应管都是采用这种制作方式完成的。
以MOSFET实现模拟开关
金氧半场效应管在导通时的沟道电阻低,而截止时的电阻近乎无限大,所以适合作为模拟信号的开关(信号的能量不会因为开关的电阻而损失太多)。金氧半场效应管作为开关时,其源极与漏极的分别和其他的应用是不太相同的,因为信号可以从金氧半场效应管栅极以外的任一端进出。对NMOS开关而言,电压最负的一端就是源极,PMOS则正好相反,电压最正的一端是源极。金氧半场效应管开关能传输的信号会受到其栅极—源极、栅极—漏极,以及漏极到源极的电压限制,如果超过了电压的上限可能会导致金氧半场效应管烧毁。
金氧半场效应管开关的应用范围很广,举凡需要用到采样保持电路(sample-and-hold circuits)或是截波电路(chopper circuits)的设计,例如模拟数字转换器(A/D converter)或是切换电容滤波器(switch-capacitor filter)上都可以见到金氧半场效应管开关的踪影。
单一金氧半场效应管开关
当NMOS用来做开关时,其源极接地,栅极为控制开关的端点。当栅极电压减去源极电压超过其导通的临界电压时,此开关的状态为导通。栅极电压继续升高,则NMOS能通过的电流就更大。NMOS做开关时工作在线性区,因为源极与漏极的电压在开关为导通时会趋向一致。
PMOS做开关时,其源极接至电路里电位最高的地方,通常是电源。栅极的电压比源极低、超过其临界电压时,PMOS开关会打开。
NMOS开关能容许通过的电压上限为(Vgate-Vthn),而PMOS开关则为(Vgate+Vthp),这个值通常不是信号原本的电压振幅,也就是说单一金氧半场效应管开关会有让信号振幅变小、信号失真的缺点。
双重(互补式)金氧半场效应管(CMOS, Complementary MOS)开关
为了改善前述单一金氧半场效应管开关造成信号失真的缺点,于是使用一个PMOS加上一个NMOS的CMOS开关(Transmission gate)成为目前最普遍的做法。CMOS开关将PMOS与NMOS的源极与漏极分别连接在一起,而基极的接法则和NMOS与PMOS的传统接法相同(PMOS的基极接到最高电压,即VDD;NMOS的基极接到最低电压,即VSS或GND)。要令开关导通时,则把PMOS的栅极接低电位(VSS或GND),NMOS的栅极接高电位(VDD)。当输入电压在(VDD-Vthn)到(VSS+Vthp)时,PMOS与NMOS都导通,而输入小于(VSS+Vthp)时,只有NMOS导通,输入大于(VDD-Vthn)时只有PMOS导通,这样做的好处是在大部分的输入电压下,PMOS与NMOS皆同时导通,如果任一边的导通电阻上升,则另一边的导通电阻就会下降,所以开关的电阻几乎可以保持定值,减少信号失真。
MOSFET常见问题
MOSFET是如何工作的?
施加在栅极上的电压通过形成或耗尽导电通道来控制从漏极到源头之间的电流。
什么是门阈电压(Vth)?
这是开始形成导电通道所需的最小门极对源电压。
什么是Rds(on)?
当MOSFET导通时,汲极与源极之间的导通电阻。较低的Rds(on)=导电损耗降低。
什么是逻辑级MOSFET?
MOSFET设计用于在低栅电压(2.5–5V)下完全导通,兼容微控制器。
MOSFET中的体二极管是什么?
在漏极和源极上固有的二极管,在反极性时导通。它在电机控制、降压转换器和H桥设计中非常重要。
如果MOSFET的栅极悬浮着会发生什么?
它可能会因为噪音而不可预测地开关。一定要用电阻拉高或低电平。
为什么MOSFET在感性负载下需要回频二极管?
以防止线圈、电机和继电器产生的高压尖峰。
什么是MOSFET安全工作区(SOA)?
它定义了电压、电流和功率耗散的安全限值,以防止热损伤或雪崩损害。
什么是MOSFET栅极电荷(Qg)?
完全开关MOSFET所需的总电荷。较低的Qg=切换更快。
MOSFET中的热失控是什么?
当热量增加Rds(on)时,会产生更多热量——导致设备故障。
什么是MOSFET驱动器,为什么需要它?
栅极驱动器提升栅极电压并提供快速的电流脉冲,确保高频下的最佳开关。
当施加正栅电压(MOS电容器)时,氧化层下方的孔位上作用了什么力?
负电场(来自正栅极)吸引电子到半导体表面并排斥空穴;空穴受到静电力推离氧化层界面。该场会引起能带弯曲,并且在足够正的栅极电压(NMOS)下,通过吸引电子形成反演层(电子通道)。
MOSFET的栅极是否与半导体有直接的物理(直流)连接?
不。栅极与半导体之间通过绝缘栅氧化层(理想情况下是SiO₂或高k介质)隔离。这意味着没有直流电流流入栅极(输入阻抗非常高)。栅极控制是电容性的——栅电压产生电场,调节通道导电性。
MOSFET的门氧化物是氧化铝还是二氧化硅?
历史上,栅极绝缘体是二氧化硅(SiO₂)。现代工艺可能使用高介电介质(如HfO₂)来减少泄漏,同时增加电容。氧化铝并不是主流MOSFET工艺中的标准栅极介质材料。
是什么决定了MOSFET的导电性?
门极到源电压(V_GS)相对于阈值(V_th)决定通道电荷。当V_GS > V_th时,形成逆转层,载流子在排水和源头之间流动。其他因素包括通道几何(W/L)、移动性、开启R_ds、温度以及缩放器件中的短通道效应。
栅极信号在电力电子中有什么重要意义?
栅极信号快速高效地切换器件,控制MOSFET何时处于导通(低电R_ds导通)或关断(截止)。适当的栅极驱动幅度和时序可最小化开关损耗,降低电磁干扰,防止桥梁穿透,并确保可靠的热行为。简而言之:良好的栅极驱动=高效、安全的切换。
功率MOSFET的开关主要用于哪个工作区域?
开关同时使用截止(OFF)和欧姆/线性区(ON)——器件被驱动为完全导通(低R_ds(导通)或完全关断。模拟放大时使用饱和(有源)区域;但切换应用时,你需要在截止和低阻线性/三极管导通状态之间切换。
MOSFET氧化层的主要作用是什么?
氧化层在电上将栅极与通道隔离,同时实现电容耦合,从而使栅极电压能够控制通道。它防止直流栅极泄漏,并允许电场形成反演通道。
MOSFET中的短信道效应(SCE)是什么?
SCE表现为通道长度缩小,包括:阈值电压衰减、漏极诱导势垒降低(DIBL)、离位泄漏增加、速度饱和、更高电场导致热载波效应,以及通道栅极控制减少。这些会降低器件的扩展性,需要工程修复(如光环植入、高介电量、多栅结构)。
为什么在MOSFET小信号模型中会存在开路电压端子?
由于栅极几乎不消耗直流电流,因此被建模为电压输入(直流电流为开路)。小信号模型使用从漏极到源的依赖电流源(g_m·v_gs)来展示输入电压如何控制输出电流;栅极节点实际上由电压源驱动,并带有相应的栅极电容以实现交流行为。
MOSFET电容是什么及其重要性?
关键的本征电容:C_gs(栅极到源)、C_gd(栅极到漏极,“米勒”电容)、C_gb(门极到本体)。它们决定了开关速度、栅极电荷(Q_g),并引起米勒效应(V_DS转变时切换速度减缓)。栅极驱动设计必须考虑这些因素,以控制开关时间和开关损耗。
MOS晶体管的控制输入端是哪个端子?
门终端控制设备。
如果MOSFET被用作放大器,它应该在哪个区域工作?
模拟放大的饱和(有源)区域——设备必须偏置,使ID依赖于V_GS,并且在工作范围内相对独立于V_DS。
栅极电压如何控制MOSFET中的电流流动?
栅极电压调节表面电势,并在氧化层下方产生或消耗载流子。V_GS > V_th时,形成导电反相通道,使电流从漏极流向源头;增加V_GS会增加通道电荷,从而增加漏斗电流(在一定范围内)。
MOSFET相较于其他晶体管的主要优势是什么?
输入阻抗非常高(栅极绝缘),实现低驱动功率;此外,具有快速开关、低导电损耗(当R_ds(导通)低时),以及易于集成的CMOS——使其非常适合数字逻辑和高效电力电子。
MOSFET的体效应如何影响作?
如果本体/基板不与电源连接,源与本体电压的差异会改变阈值电压(本体效应):V_th随着源-本体电压变得更正(对于NMOS)而增加,从而减少驱动并改变设备行为。在模拟和混合信号设计中非常重要。
如何用万用表测试MOSFET?
在二极管模式下:检查本体二极管(漏极→源显示二极管用于NMOS),确认栅极与漏极/源极之间无短路(栅极应为开启),然后施加少量栅极电荷(或使用欧姆模式),观察极极驱动时漏极源是否导通。如需更全面的测试,可以使用曲线示踪器或晶体管测试仪测量V_th、开(R_ds)和泄漏。
MOSFET如何用作电阻?(需要什么连接?)
要作为线性电阻工作,将栅极偏置使器件部分导通,同时保持V_DS小,保持在三极管/线性区间。实际上,这意味着在阈值以上应用固定的V_GS,并使用低 V_DS 的设备。把门连接到源头会关闭;将栅极连接到漏极,形成二极管连接的器件,而非线性电阻。所以你不会把门和源绑定;你应用的是受控门偏置。



 计算机仿真曲线。临界电压在0.45V左右。右图展现的纳米线MOSFET中反型沟道的形成(电子密度的变化)。
计算机仿真曲线。临界电压在0.45V左右。右图展现的纳米线MOSFET中反型沟道的形成(电子密度的变化)。 是基极与源极之间无电位差时的临界电压,
是基极与源极之间无电位差时的临界电压, 是衬底效应参数,
是衬底效应参数, 则是与半导体能阶相关的参数(禁带中线与费米能级的差值)。
则是与半导体能阶相关的参数(禁带中线与费米能级的差值)。